Исследование параметров и характеристик обогащенно-планарных IGBT с малыми потерями на напряжение 1200 В
Современное развитие силовых полупроводниковых приборов, ориентированных для применения в энергосберегающем оборудовании, связано с разработками и производством IGBT-модулей. Эти уникальные приборы стали основной компонентной базой преобразовательной техники в диапазоне мощностей 0,1–10000 кВт и уже во многом определяют состояние и темпы развития экономик высокоразвитых стран. Следует также отметить, что IGBT-технологии, повышая эффективность потребления электрической энергии, успешно решают задачи глобального характера, связанные, прежде всего, с уменьшением выбросов CO2 в атмосферу. В связи с этим во многих странах освоение IGBT-технологий находится в статусе приоритетных задач, а в Китае и Индии производство IGBT-кристаллов и модулей целенаправленно поддерживается правительствами этих стран.
В России IGBT-модули производятся несколькими электронными компаниями. Однако большинство из них используют импортную комплектацию, что не всегда приемлемо, например при выполнении стратегически важных проектов государственного значения. При поддержке Минпромторга РФ ОАО «Ангстрем» и ОАО «Электровыпрямитель» в рамках Соглашения между предприятиями о стратегическом сотрудничестве в сфере силовой электроники и системотехники проводят работы по разработке и созданию производства конкурентоспособных IGBT- и FRD-кристаллов и силовых модулей на их основе. ОАО «Ангстрем» производит расчеты, проектирование, изготовление и тестирование кристаллов IGBT и FRD. ОАО «Электровыпрямитель» осуществляет сборку этих кристаллов в модули, проводит исследования параметров и характеристик IGBT-модулей в предельных режимах в широком диапазоне температур. По результатам исследований выполняются корректирующие действия, направленные на улучшение параметров кристаллов. Итерационный цикл в разработке IGBT и FRD повторяется до выхода на требуемые параметры силовых модулей. IGBT и комплектные FRD на напряжение 1200 В разрабатывались для работы в ключевых режимах на частотах до 15 кГц для различных применений, например в промышленных приводах. Это требует от IGBT низких статических и динамических потерь, прямоугольную область безопасной работы (SOA), высокую устойчивость к короткому замыканию.
Технология кристаллов IGBT
Производство кристаллов в ОАО «Ангстрем» базируется на технологической линии, рассчитанной на работу с пластинами кремния диаметром 150 мм. Минимальные топологические размеры 0,6 мкм. Производительность линии до 10 000 пластин c кристаллами IGBT и мощных ДМОП-транзисторов в месяц.
Проведены исследования различных вариантов конструкции кристалла IGBT для обеспечения минимальных статических и динамических потерь, высокой устойчивости к перегрузкам по току и напряжению. На рис. 1 представлены две последние версии кристаллов IGBT, изготовленные по технологии NPT+ с улучшенными свойствами микроячеек, которые показали хорошие результаты тестирования в IGBT-модулях. На рис. 1а показано поперечное сечение кристалла IGBT версии 1 (V1) со стандартным размером транзисторных микроячеек. Для снижения входной емкости в версии V1 было произведено локальное увеличение толщины подзатворного окисла.

Рис. 1. Поперечное сечение планарных NPT+ IGBT:
а) стандартная микроячейка (версия V1);
б) ячейка с уменьшенным шагом (версия V2)
На рис. 1б представлена структура IGBT версии 2 (V2), отличающаяся от версии V1 меньшими размерами микроячеек, что позволило уменьшить эффект дренажа p-n-p-транзистора и повысить концентрацию носителей заряда вблизи поверхности. Данный вариант IGBT спроектирован с расчетом на более низкий уровень потерь при переключении и меньший ток короткого замыкания без изменения VCE(sat) благодаря сокращению длины канала МОП-транзистора и уменьшению площади коллектора p-n-p-транзистора.
В исследованиях IGBT использовались кристаллы частотного диода типа An75FRD12 с эпитаксиальной структурой разработки ОАО «Ангстрем». Он является важным компонентом для защиты IGBT при его работе в схемах с индуктивностью. Свойства этих диодов во многом определяют динамические характеристики и надежность IGBT-модулей. Его физические параметры были также оптимизированы для низких статических и динамических потерь.
Силовые IGBT-модули
Сборка кристаллов в модули производилась на действующей в ОАО «Электровыпрямитель» технологической линии с применением узлов и деталей собственного изготовления. Для исследований параметров и характеристик новых IGBT и FRD-кристаллов использовалась стандартная конструкция IGBT-модуля MI3 шириной 34 мм (рис. 2а).
Для максимального приближения условий испытаний исследуемых образцов IGBT и FRD к реальным режимам работы на индуктивную нагрузку, которые имеют место, например, в инверторах напряжения, IGBT-модули изготавливались по схеме полумоста (рис. 2б) или схеме чоппера (рис. 2в). В одном корпусе модуля располагались два кристалла NPT+ IGBT и два кристалла FRD, включенных антипараллельно, по одной паре в каждом ключе. Кристаллы IGBT NPT+ и FRD разрабатывались на ток 75 А, поэтому в данной конструкции модулей может быть реализована система параметров 2×50(75) А/1200 В.
Электрические характеристики NPT+ IGBT и FRD
Для проверки работоспособности разработанных кристаллов NPT+ IGBT и FRD и оценки их соответствия требованиям промышленных приводов были проведены всесторонние исследования статических и динамических параметров кристаллов в IGBT-модулях в предельных режимах при комнатной и максимально допустимой температурах. Приборы испытывались на устойчивость к выключению с двойного тока нагрузки (RBSOA) и к току короткого замыкания (SCSOA) при переключении с номинального напряжения. Были измерены входные, выходные и передаточные характеристики IGBT-модулей. Исследовались зависимости динамических параметров и энергия потерь в IGBT и FRD от сопротивления входного резистора и тока коллектора при максимальной температуре. Для сравнения одновременно испытывались IGBT-модули, собранные на кристаллах IGBT и FRD других производителей.
Измерения и исследования параметров и характеристик NPT+ IGBT и FRD производились на внешних выводах силовых модулей. Измерения учитывали падения напряжения на кристаллах, металлизации керамических плат, алюминиевой проволоке, медных перемычках и силовых выводах. При измерениях использовалось оборудование фирм LEMSYS и ОАО «Электровыпрямитель», методы испытаний — в соответствии со стандартом IEC 60747-9.
Статические параметры
Проведены измерения статических параметров IGBT-модулей с кристаллами NPT+ IGBT и FRD: напряжение пробоя «коллектор–эмиттер» VBR(CES), ток утечки «коллектор–эмиттер» ICES, пороговое напряжение «затвор–эмиттер» VGE(th), ток утечки «затвор–эмиттер» IGES, напряжение насыщения «коллектор–эмиттер» VCE(sat), прямое падение напряжения диода обратного тока VF, входная емкость транзистора Ciss.
На рис. 3–5 представлены вольт-амперные характеристики во включенном состоянии IC = f(VCE), IF = f(VF) и передаточные характеристики IC = f(VGE) транзисторов NPT+ IGBT версий V1 и V2 и диодов An75FRD12. Они показывают, что кристаллы IGBT NPT+ и FRD ОАО «Ангстрем» имеют положительный температурный коэффициент уже при малых токах коллектора, что позволяет использовать их в параллельных соединениях при производстве мощных модулей, рассчитанных на токи до 2000 А. На этих же рисунках представлены статические характеристики зарубежных аналогов IGBT и FRD, изготовленных по NPT-технологии и технологии EmCon соответственно.

Рис. 3. Вольт-амперные характеристики IGBT во включенном состоянии IC = f(VCEon):
а) версия V1;
б) версия V2;
в) NPT-аналог
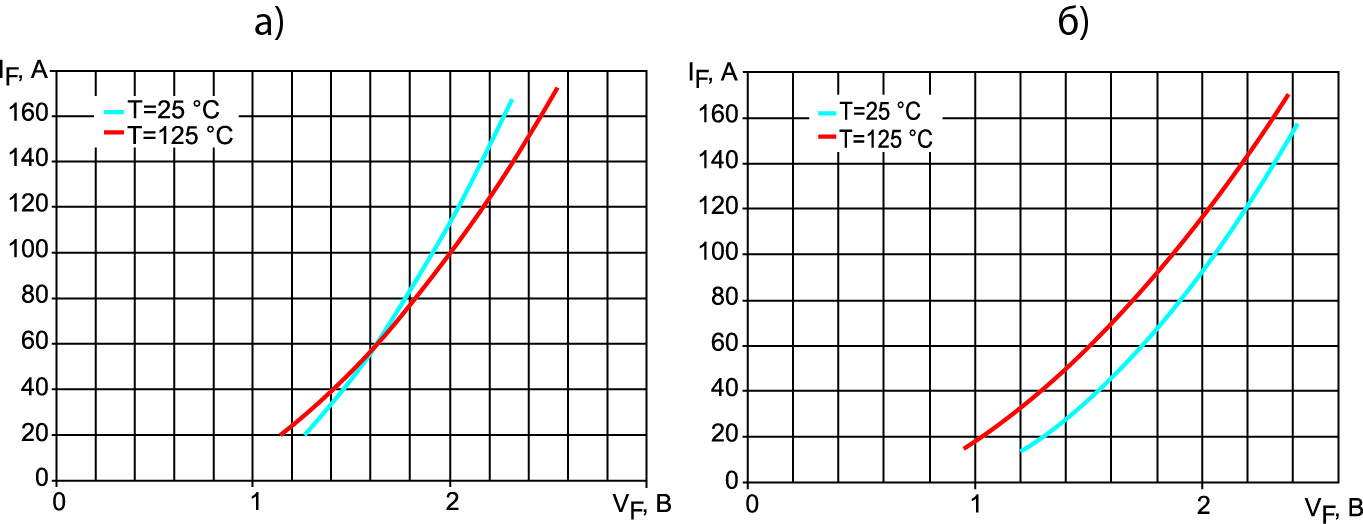
Рис. 4. Прямые вольт-амперные характеристики антипараллельных диодов IF = f(VF):
а) An75FRD12;
б) FRD EmCon
Результаты измерений статических параметров транзисторов NPT+ IGBT V1 и V2, диода An75FRD12, NPT-аналога и FRD EmCon, собранных в IGBT-модули (рис. 2а) по схеме рис. 2б, представлены в таблице 1.
|
Тип прибора |
Параметры и режимы измерений |
||||||||||
|
VBR(CES) тип, B |
ICES тип, мA |
IGES тип, нA |
VGE(th), B |
VCE(sat) тип, B |
VF тип, B |
Ciss, нФ |
|||||
|
+25 °C; |
+125 °C; |
+25 °C; |
+125 °C; |
+25 °C; |
+25 °C; |
+25 °C; |
+125 °C; |
+25 °C; |
+125 °C; |
+25 °C; |
|
|
М2ТКИ-50-12А |
1340 |
1490 |
0,25 |
2,5 |
15 |
5,1–5,3 |
2,3 |
2,5 |
1,55 |
1,55 |
4,7 |
|
М2ТКИ-50-12А (оптимизированная ячейка, технология NPT+, версия V2) |
1270 |
1430 |
0,1 |
2,0 |
70 |
4,2–4,6 |
2,0 |
2,2 |
1,55 |
1,55 |
4,6 |
|
Зарубежный аналог (технология NPT) |
1330 |
1450 |
0,1 |
0,5 |
150 |
5,4–5,6 |
2,55 |
3,0 |
1,8 |
1,7 |
5,3 |
По рис. 3–5 и табличным данным видно, что основные статические параметры IGBT-модулей, изготовленных на основе 1200-В кристаллов NPT+ IGBT и An75FRD12 компании ОАО «Ангстрем», практически совпадают с зарубежным NPT-аналогом, а по параметрам VСE(sat) и VF значительно превосходят его. Низкие значения напряжения насыщения демонстрирует версия V2, величина которых приближается к значениям, получаемым IGBT со структурой trench gate. Следует отметить, что из всех трех исследованных вариантов IGBT V2 имеет наибольшую ширину канала. Кроме этого, как и в версии V1, IGBT V2 имеет увеличенную концентрацию носителей вблизи ячеек в силовом MOSFET за счет уменьшения явления дренажа неосновных носителей заряда. Эти особенности конструкции и технологии изготовления полевой части IGBT V2 оказались решающими в получении очень низких VСE(sat), несмотря на достаточно протяженную дрейфовую область транзистора.
Динамические параметры
При измерении динамических параметров IGBT и FRD важными факторами являются схема и условия измерений. Для наших исследований использовалась полумостовая испытательная схема, показанная на рис. 6. Она обеспечивает взаимодействие между IGBT и антипараллельным диодом при переключении так же, как и в реальных применениях. Режимы измерения динамических параметров IGBT и FRD выбраны не для определения характеристик отдельных приборов как таковых, а с учетом условий эксплуатации IGBT-модулей при индуктивной нагрузке. Величина индуктивности в используемой схеме измерений составляет около 220 нГн. Следует отметить, что в выбранной схеме измерений характеристики включения будут зависеть от способности IGBT задавать необходимые скорости коммутации di/dt при восстановлении антипараллельного диода. Причем на энергию потерь в IGBT-модуле при включении влияют как потери в самом IGBT, так и потери при обратном восстановлении антипараллельного диода.
Были измерены переходные характеристики переключения модулей при напряжении шины постоянного тока 600 В, токе коллектора 50–75 А и температуре Tj = +125 °С. Величина сопротивления внешнего резистора RG варьировалась в диапазоне 5–33 Ом.
Характеристики включения IGBT версии V1 и версии V2 при RG = 22 Ом и Tj = +125 °C представлены на рис. 7.

Рис. 7. Характеристики включения IGBT:
а) версия V1;
б) версия V2 (режим измерения: VCC = 600 В, IC = 75 А, RG = 22 Ом, Tj = +125 °C)
Из характеристик включения видно, что IGBT версии V2 при равных режимах измерений включается значительно быстрее, чем IGBT версии V1. Скорость нарастания тока при включении IGBT V2 (diC/dt) составляет около 1000 А/мкс, у IGBT V1 diC/dt = 350 А/мкс. Высокое diC/dt = diF/dt вместе с высоким пиковым током дает возможность восстанавливать антипараллельный диод намного быстрее, что обеспечивает IGBT V2 меньшие потери включения, чем в IGBT V1.
Другим необходимым требованием к IGBT является низкое перенапряжение при выключении. Эти перенапряжения могут возникать в контурах коммутации в схемах с высокой рассеянной индуктивностью, в том числе со стороны шины постоянного тока. Для минимизации перенапряжений в цепи «коллектор–эмиттер» и снижения вероятности пробоя кремниевых структур IGBT должны иметь достаточно низкую скорость спада тока при выключении. Подобная характеристика присуща IGBT со структурой NPT, у которого при выключении всегда имеет место мягкий спад тока коллектора, обусловленный оставшимися в n-базе неравновесными носителями вблизи анодного эмиттера. Мягкий характер спада тока коллектора не вызывает к тому же процесс схлопывания с осцилляциями и тем самым исключает связанные с этим процессом перенапряжения и высокочастотные электромагнитные помехи. С другой стороны, низкая скорость спада тока при выключении может привести к повышению энергии потерь. В этом случае должен быть найден компромисс между статическими и динамическими потерями с учетом рабочей частоты коммутации. В частности, при низкочастотном применении (частоты меньше 8 кГц) увеличение потерь при выключении будет мало сказываться на полных потерях.
На рис. 8 представлены характеристики выключения IGBT V1 и версии V2 при Tj = +125 °С.

Рис. 8. Характеристики выключения:
а) IGBT V1;
б) IGBT V2 (режим измерения: VCC =600 В, IC = 75 А, RG = 22 Ом, Tj = +125 °C)
Полученные характеристики выключения IGBT V1 и IGBT V2 практически идентичны. Это объясняется одинаковыми дизайном, физическими свойствами составных p-n-p-транзисторов и исходных кремниевых пластин, которые использовались при изготовлении IGBT обеих версий. Видно, что при выключении ток коллектора плавно спадает до нуля, а на транзисторе, даже при достаточно большой индуктивности рассеивания схемы, не возникает высоких перенапряжений (DV = Ls × diC/dt не превышает 200 В). Таким образом, транзистор вполне может работать в схемах привода с входным постоянным напряжением до 900 В либо при более низких напряжениях, обеспечивая пользователей большей степенью свободы при проектировании, не особенно заботясь об оптимизации конструкции силовой схемы.
По результатам измерения характеристик переключения были определены основные динамические параметры IGBT и FRD версий V1, V2 и зарубежного аналога, которые обычно специфицируются в информационных материалах и документации изготовителя. Для IGBT это: время задержки включения td(on), время нарастания тока tr, время задержки выключения td(off), время спада тока tf; для FRD: время обратного восстановления trr, заряд обратного восстановления Qrr, ток обратного восстановления IRM.
Динамические параметры IGBT и FRD, измеренные в режиме VCC = 600 В, IC = 50 А, RG = 22 Ом, Tj = +125 °C, представлены в таблице 2.
|
Тип прибора |
Динамические параметры |
|||||||||
|
Транзисторы |
Диоды |
|||||||||
|
td(on) тип, мкс |
tr тип, мкс |
Eon тип, мДж |
td(off) тип, мкс |
tf тип, мкс |
Eoff тип, мДж |
trr тип, мкс |
Qrr тип, Кл |
Erec, тип, мДж |
Etot тип, мДж |
|
|
М2ТКИ-50-12А |
0,3 |
0,14 |
12,1 |
0,31 |
0,66 |
8,35 |
0,34 |
6,3 |
1,6 |
22 |
|
М2ТКИ-50-12А |
0,38 |
0,08 |
6,4 |
0,43 |
0,64 |
8,1 |
0,2 |
7,0 |
2,0 |
16,5 |
|
Зарубежный аналог (технология NPT) |
0,35 |
0,084 |
8,34 |
0,365 |
0,31 |
4,7 |
0,42 |
9,8 |
4,0 |
17,0 |
Динамические параметры IGBT в сильной степени зависят от режима измерений: температуры Tvj, напряжения шины постоянного тока VCC, тока коллектора, скорости изменения тока dIC/dt или dIF/dt. Кроме этого, характеристики включения IGBT, измеренные в полумостовой испытательной схеме (рис. 6), зависят не только от собственных физических свойств, но и от свойств антипараллельного диода VD2 нижнего ключа VT2 и сопротивления затворного резистора RG.
На рис. 9 представлены зависимости динамических параметров IGBT версии V2 и антипараллельного диода An75FRD12 от сопротивления входного резистора и тока коллектора.

Рис. 9. Зависимость динамических параметров IGBT V2 и An75FRD12 при VСС = 600 V, Tj = 125 °С:
а) от сопротивления входного резистора (IC = 50 А);
б) от тока коллектора (RG = 22 Ом)
Из рис. 9а видно, что с уменьшением сопротивления входного резистора (с увеличением di/dt коммутации) уменьшаются практически все времена переключения и их составляющие, кроме времени спада тока коллектора tf, которое в большей степени зависит от физических свойств и толщины n-базы составного p-n-p-транзистора.
Слабая зависимость td(on), tr и td(off) от тока коллектора в диапазоне 20–80 А, а также резкий спад tf с ростом тока коллектора (рис. 9б) еще раз подтверждают, что кристаллы IGBT V2 обладают высокой нагрузочной способностью и, несмотря на сравнительно небольшую активную площадь (79 мм2), могут быть использованы в качестве единичного 75-А кристалла в модулях на токи 75, 150, 300 А и более.
Энергия потерь при переключении
Важным параметром транзисторов, определяющим мощность потерь при работе IGBT в частотном режиме, является энергия потерь при переключении:
Esw = Eon + Eoff,
где Eon, Eoff — энергия потерь в IGBT соответственно при включении и выключении. Поскольку транзистор работает в модуле в паре с антипараллельным диодом, необходимо учитывать и энергию потерь Erec, выделяющуюся в кристалле FRD во время выключения диода. Суммарная энергия потерь, возникающая в IGBT-модулях с IGBT и антипараллельными FRD при коммутации тока:
Etot = Eon + Eoff + Erec.
Энергия потерь рассчитывается как максимальное значение интеграла мгновенной мощности, определяемой из характеристик переключения:
На примере IGBT версии V2 ниже показаны (рис. 10) зависимости энергии потерь Eon, Eoff и Erec в IGBT-модуле от сопротивления входного резистора (рис. 10а) и тока коллектора (рис. 10б). На этих же рисунках показаны кривые зависимости Etot = f(Rg, IC).

Рис. 10. Зависимость энергии динамических потерь при переключении в IGBT версии V2 и диоде An75FRD12 при VСС = 600 В, Tj = 125 °С:
а) от сопротивления входного резистора (IC = 50 А);
б) от тока коллектора (RG = 22 Ом)
На рис. 10а видно, что с уменьшением сопротивления входного резистора от 33 до 5 Ом энергия потерь при включении уменьшается на 47%, при выключении она практически не меняется, а при обратном восстановлении FRD увеличивается почти вдвое, оставаясь при этом существенно меньше по сравнению с Eon и Eoff. Суммарная энергия потерь Etot с уменьшением RG снижается на 11%. С ростом тока коллектора динамические потери линейно возрастают (рис. 10б).
Для сравнения на рис. 11 представлены зависимости суммарной энергии потерь Etot от тока коллектора для всех трех исследованных пар кристаллов IGBT и FRD: версия V1/An75FRD12, версия V2/An75FRD12, NPT-аналог/FRD EmCon.

Рис. 11. Зависимость суммарной энергии динамических потерь от тока коллектора: версия V1/An75FRD12 (синий цвет), версия V2/An75FRD12 (красный цвет), NPT-аналог/FRD EmCon (зеленый цвет)
Следует констатировать, что суммарные динамические потери пары IGBT V2 и An75FRD12, собранных в модуль по полумостовой схеме, равны и даже немного (~ на 5%) ниже в диапазоне токов 60–100 А динамических потерь Etot зарубежного аналога с кристаллами NPT IGBT и FRD EmCon. Суммарные динамические потери у пары IGBT V1 и An75FRD12 выше на 10% при токе коллектора 20 А и на 35% при токе 100 А по сравнению с парой IGBT V2 и An75FRD12. При этом следует учесть, что статические потери у транзисторов версии V2 на 41%, а у версии V1 на 19% ниже статических потерь зарубежного NPT-аналога.
Устойчивость к короткому замыканию
Устойчивость IGBT-модулей к короткому замыканию очень важна для применения их в схемах электропривода. Характеристики короткого замыкания исследуемых версий IGBT проверялись в той же полумостовой испытательной схеме (рис. 6) в режиме КЗ первого рода. Этот режим имеет место в случае, когда короткое замыкание уже присутствует в схеме, то есть ток через IGBT нарастает сразу после включения с нулевого значения до тока КЗ. Он реализуется путем прямого подключения заряженной емкости фильтра питания к коллектору и эмиттеру и включения IGBT на заданное время. Поскольку характеристики включения и напряжение насыщения IGBT версий V1 и V2 отличаются, режимы короткого замыкания на этих приборах были различны.
На рис. 12а представлены осциллограммы токов и напряжений при коротком замыкании IGBT V2 в течение специфицированного времени 10 мкс в режиме VCC = 900 B, RG = 22 Ом, VGE = ±15 В, Tj = +125 °C. Видно, что транзистор успешно выдержал этот режим короткого замыкания, причем через IGBT протекал максимальный импульс тока амплитудой 430 А, что почти в шесть раз больше номинального значения. Одновременно с воздействием тока КЗ транзистор находился под высоким напряжением амплитудой 1100 В (с учетом индуктивного пика при выключении).

Рис. 12. Осциллограммы токов короткого замыкания:
а) IGBT версия V2 (режим: VCC = 900 B, tp = 10 мкс, RG = 22 Ом, VGEon = +15 В, VGEoff = –15 В, Tj = +125 °C);
б) IGBT версия V1 (режим: VCC = 900 B, tp = 40 мкс, RG = 22 Ом, VGEon = +15 В, VGEoff = –15 В, Tj = +125 °C)
На рис. 12б изображены формы импульсов токов и напряжений при коротком замыкании IGBT версии V1. Схема и режим испытаний такие же, как и у транзисторов версии V2. Испытания показали, что эти приборы, обладая низкой прямой транспроводимостью (рис. 5а), ограничивают ток короткого замыкания на уровне четырехкратного номинального тока. Была проведена серия последовательных испытаний IGBT V1 при VCC = 900 В, VGE = ±15 В и Tj = +125 °C с длительностью импульсов тока КЗ tSC = 10, 20, 30 и 40 мкс.
Транзисторы IGBT V1 успешно выдержали эти испытания, продемонстрировав тем самым высочайшую прочность при коротком замыкании в течение 40 мкс при повышенном напряжении и температуре без ухудшения характеристик.
Заключение
Представленные в данной работе результаты исследований показывают, что новая технология NPT+ IGBT ОАО «Ангстрем» обеспечивает высокий уровень параметров и характеристик IGBT-модулям с напряжением 1200 В: низкие напряжения насыщения, превосходные характеристики переключения и короткого замыкания. Сделан важный шаг к широкому использованию отечественных кристаллов IGBT и модулей на их основе в промышленных применениях. Новые разработки в технологии IGBT продолжаются. Они направлены на повышение рабочего напряжения, улучшение соотношения статических и динамических потерь, обеспечение контролируемого и мягкого выключения транзисторов и диодов.





 10 января, 2008
10 января, 2008