Новые карбид-кремниевые модули на кристаллах второго поколения
Введение
Появление силовых модулей на основе карбида кремния (SiC) — это большой эволюционный скачок в развитии современной силовой электроники. Из-за физических свойств этого п/п-материала преобразователи на основе SiC мощнее и компактнее в сравнении с кремниевыми. Компания Mitsubishi Electric начала разработку первых SiC-чипов еще в 1990 году и почти за три десятилетия выпустила на рынок большое количество карбид-кремниевых модулей в разных классах напряжений, делая основной акцент на высокомощные приборы с кристаллами большой площади. За счет использования этих модулей удалось достичь высочайшей производительности и плотности мощности в таких применениях, как лифты, ИБП, солнечная энергетика, ж/д-тяга.
В статье предложена последняя информация о разработках компании в области карбид-кремниевых п/п. В классах напряжения 1200 и 1700 В представлено второе поколение кристаллов, приведены технические характеристики и сравнение с предыдущим поколением. Для более высоких классов напряжений предложено решение одной из актуальнейших проблем на сегодня — деградации внутреннего диода SiC MOSFET-чипов. В данный момент общеизвестным решением которой является антипараллельное включение диода Шоттки с транзистором. Специфический подход Mitsubishi Electric состоит в том, чтобы совместить диод и транзистор в одном кристалле — это позволяет существенно увеличить плотность мощности. Подробные сведения приведены в заключительной части статьи.
SiC-модули на базе шестидюймовых пластин
На рис. 1 изображен модуль, построенный на 4H-SiC MOSFET-кристаллах второго поколения. Новое поколение чипов на 1200 и 1700 В (описание чипов на 600 В можно найти в [1]) производится на шестидюймовых пластинах, имеет оптимизированный эпитаксиальный слой и новую технологию легирования — рис. 2 [2]. Все это увеличивает надежность оксидной изоляции затвора и снижает потери проводимости.

Рис 1. Второе поколение карбид-кремниевого модуля на 1200 В с RTC-защитой от КЗ
На рис. 3 показано сопротивление Ron,sp MOSFET-чипов (приведенное для 100 А/см2) первого и второго поколения на 1200 В при комнатной температуре. Соответственно, за счет оптимизации структуры транзистора снижение сопротивления составляет 33% — с 4,5 до 3 мОм·см2.
При уменьшении размеров ячеек область JFET-перехода также сужается, что приводит к увеличению суммарного сопротивления транзистора. Однако за счет особого легирования области JFET компании Mitsubishi Electric удалось решить эту проблему. На рис. 4 показано снижение сопротивления канала благодаря применению новой технологии легирования JFET-перехода. Это позволяет планарной SiC MOSFET-структуре конкурировать с распространенным сегодня траншейным типом транзисторов (рис. 5), одновременно оставаясь более простой в производстве.

Рис. 5. Сравнение сопротивления канала SiC MOSFET-чипов на 1200 В с планарной и траншейной структурой
Динамические потери SiC-кристаллов второго поколения были также сокращены за счет уменьшения емкости затвор-сток (емкости Миллера). Это увеличило скорость переключения транзистора и снизило потери на включение и выключение на 23 и 37% соответственно в сравнении с предыдущим поколением (рис. 6).
Производительность полумостового модуля на 300 А, 1700 В, имеющего SiC MOSFET-чипы с обновленной структурой, показана в [3]. Так, при токе 300 А и температуре чипа +150 °C достигается падение напряжения сток-исток VDS(on) в 2,75 В. Энергии включения и выключения при тех же параметрах составляют 12 и 3 мДж соответственно (RG = 1,6 мОм). На сегодня это одни из лучших в мире значений для 300‑А модуля 17‑го класса.

Рис. 6. Осциллограммы включения (слева) и выключения (справа) рабочего тока SiC-чипов на 1200 В первого и второго поколений
Среди других факторов, ограничивающих возможность снижения сопротивления канала RDC(on), следует отметить и сопутствующее снижение стойкости чипа к короткому замыканию. Вкупе с быстрым нарастанием тока это делает проблемой защиту SiC-модулей от КЗ. В связи с чем компания Mitsubishi Electric разработала систему контроля тока в реальном времени (Real Time Control, RTC) и применила ее еще в первом поколении SiC [4]. Она минимизирует время реакции защиты и не дает току развиться до критической величины в случае КЗ.

Рис. 7. Схема защиты от короткого замыкания в реальном времени (RTC)
На рис. 7 и 8 показана функциональная схема системы RTC, а также осциллограммы тока и напряжений в SiC-модуле при возникновении КЗ. При превышении током транзистора пороговой величины система обратной связи снижает напряжение на затворе, ограничивая результирующий ток и, как следствие, мгновенную мощность, выделяемую в чипе. Таким образом, система RTC снимает с разработчика преобразователя такую нетривиальную задачу, как создание драйвера для SiC-модуля с высокоскоростной защитой от КЗ. Успешное применение данной системы в SiC-приборах первого поколения стало основанием для расширения модельного ряда модулей второго поколения с RTC-защитой — данная опция доступна для всех модулей в пределах 300–1200 А (таблица).

Рис. 8. Осциллограмма работы системы RTC при возникновении КЗ
|
Модули |
1200 В |
1700 В |
||
|
Без RTC |
С RTC-защитой |
Без RTC |
С RTC-защитой |
|
|
300 А |
– |
«4-в-1» |
– |
«2-в-1» |
|
400 А |
«4-в-1» |
– |
||
|
600 А |
– |
«2-в-1» |
||
|
800 А |
«2-в-1» |
|||
|
1200 А |
– |
|||
Примечание. «2‑в‑1» — полумостовой модуль; «4‑в‑1» — H‑мост.
Высоковольтные SiC-модули
Говоря о высоковольтных карбид-кремниевых кристаллах, нельзя не затронуть широко обсуждаемую проблему ухудшения свойств полупроводниковой структуры, известную как биполярная деградация (рис. 10). Суть ее в том, что обратный ток, текущий через паразитный диод MOSFET-чипа, может вызывать локальные дефекты в SiC-структуре. Эти дефекты могут стать причиной необратимых изменений характеристик кристалла [5, 6].

Рис. 9. Высоковольтные SiC-модули на 3,3 кВ в корпусе LV100 (слева) и 6,5 кВ в корпусе HV100 (справа)
Для решения проблемы деградации компания Mitsubishi Electric в своих SiC-модулях использует диод Шоттки, включенный параллельно MOSFET-транзистору. При этом величина прямого падения напряжения в диоде Шоттки ниже, чем у паразитного диода, благодаря чему подавляющая часть обратного тока течет через диод Шоттки. Данный подход хорошо зарекомендовал себя более чем за четыре года эксплуатации SiC-модулей на 3300 В.
Основной недостаток данного подхода состоит в том, что минимальная площадь диодного чипа, необходимого для перехвата обратного тока, зависит от класса напряжения прибора. Например, если для класса напряжения 3300 В площадь кристалла диода Шоттки в 1,3 раза больше площади MOSFET-чипа, то для класса напряжения 6500 В разница в площади будет трехкратной. Помимо увеличения стоимости, полезная площадь силового модуля в этом случае используется неэффективно, поэтому Mitsubishi Electric выбрала другой подход для своих высоковольтных SiC-модулей.
Перспективным решением видится диод Шоттки, встроенный непосредственно в кристалл MOSFET-транзистора. Такая технология уже была реализована для транзисторов на 6500 В и описана в [7, 8]. Как показано на рис. 11, новая MOSFET-структура со встроенным диодом Шоттки существенно снижает результирующую площадь чипов и тем самым повышает плотность мощности модуля.
Более того, встроенный в чип MOSFET-транзистора диод Шоттки позволяет улучшить динамические параметры модулей, как показано в [9] для 3300 В. На рис. 12 приведены характеристики переключения модулей со встроенным в транзистор диодом Шоттки (A — голубой), отдельными чипами диода Шоттки (B4 — зеленый), а также MOSFET-кристаллом без внешнего диода (C — красный). Из осциллограмм видно, что MOSFET-чипы со встроенным диодом Шоттки имеют наиболее низкие потери, что объясняется самым низким суммарным зарядом затвора Qtot. В результате их динамические потери при включении приблизительно на 20% ниже в сравнении с классическим подходом с отдельным диодом. К тому же совмещение диода Шоттки и транзистора в одном кристалле полностью исключает деградацию структуры транзистора и дает непревзойденную плотность мощности.

Рис. 12. Схематичное изображение занимаемой чипами площади (а), а также осциллограммы выключения тока для трех вариантов (б)
Заключение
Силовые преобразователи на базе карбид-кремниевых модулей — следующий важный этап развития силовой электроники. Благодаря им становятся доступными высочайшая плотность мощности и КПД, недостижимые ранее. Компания Mitsubishi Electric имеет широкую линейку мощных SiC-модулей во всех классах напряжений. В статье представлено второе поколение SiC-модулей в классах напряжения 1200 и 1700 В с улучшенной производительностью, а также RTC-технологией защиты от КЗ. Для классов напряжения 3300 и 6500 В представлена новейшая технология совмещения диода Шоттки и MOSFET-транзистора в одном чипе, позволяющая увеличить плотность мощности SiC-модулей. После выпуска первых SiC-модулей в начале 1990‑х сегодня компания Mitsubishi Electric предлагает широкий модельный ряд в диапазоне напряжений 1200–3300 В. SiC-модули на более высокое напряжение находятся в разработке.
- Ebiike Y., Tanioka T., Furuhashi M., Osawa A., Imaizumi M. Charac-teristics of High-Threshold-Voltage Low-Loss 4H-SiC MOSFETs with Improved MOS Cell Structure // Materials Science Forum. 2016. No. 858.
- Tanioka T., Ebiike Y., Oritsuki Y., Imaizumi M., Tarutani M. High Performance 4H-SiC MOSFETs with Optimum Design of Active Cell and Re-Oxidation. PCIM Europe, Nuremberg, Germany, 2018.
- Hamano K., Oritsuki Y., Tanioka T., Hanano N., Imaizumi M., Suekawa E., Tarutani M., Miyazaki Y. 2nd generation High performance 4H-SiC MOSFETs with 1.7 kV rating for high power applications. PCIM Europe, Nuremberg, Germany, 2019.
- Thal E., Masuda K., Wiesner E. New 800A/1200V Full SiC Module // Bodo’s Power Systems. 2015. April.
- Jacobsson H. et al. Properties of Different Stacking Faults that Cause Degr-adation in SiC PiN Diodes. Materials Science Forum. Switzerland, 2003.
- Persson P. O. A. et al. Structural defects in electrically degraded 4H-SiC p+/n–/n+ diodes // Applied Physics Letters. 2002. Vol. 80. No. 25.
- Hino S., Hatta H., Sadamatsu K., Nagahisa Y., Yamamoto S., Iwamatsu T., Yamamoto Y., Imaizumi M., Nakata S., Yamakawa S. Demonstration of SiC-MOSFET Embedding Schottky Barrier Diode for Inactivation of Parasitic Body Diode // Material Science Forum. 2017. Vol. 897.
- Kawahara K., Hino S. et al. 6.5 kV Schottky-Barrier-Diode-Embedded SiC-MOSFET for Compact Full-Unipolar Module. 29th Int. Symposium on Power Semiconductor Devices & ICs. Sapporo, 2017.
- Tominaga T., Hino S., Mitsui Y., Nakashima J., Kawahara K., Tomohisa S., Miura N. Superior Switching Characteristics of SiC-MOSFET Embedding SBD. 31stInternational Symposium on Power Semiconductor Devices & ICs. Shanghai, China, 2019.
- Mitsubishi Electric Corporation, Mitsubishi Electric’s New 6.5 kV Full-SiC Power Semiconductor Module Achieves World’s Highest Power Density // Japan: Press Release 2018. No. 3164.
- Yamada J., Thal E. SiC Power Modules for a Wide Application range // Bodo’s Power Systems. 2017. September.
- Soltau N., Wiesner E., Tsuda R., Hatori K., Uemura H. Impact of Gate Control on the Switching Performance of a 750A/3300V Dual SiC-Module. 20th European Conference on Power Electronics and Applications (EPE’18 ECCE Europe). Riga, 2018.
- Толстопятов В., Солтау Н., Виснер О., Хатори K. Полный карбид-кремниевый MOSFET-модуль на 3,3 кВ: новый класс эффективности тяговых инверторов // Силовая электроника. 2018. № 2.
- Толстопятов В., Ямада Д., Таль Э. Повышая скорость: SiC-модули Mitsubishi Electric // Силовая электроника. 2019. № 2.


![Типовые выходные характеристики SiC MOSFET на 1200 В первого и второго поколений [2]](https://power-e.ru/wp-content/uploads/10_80-03-400x300.jpg)
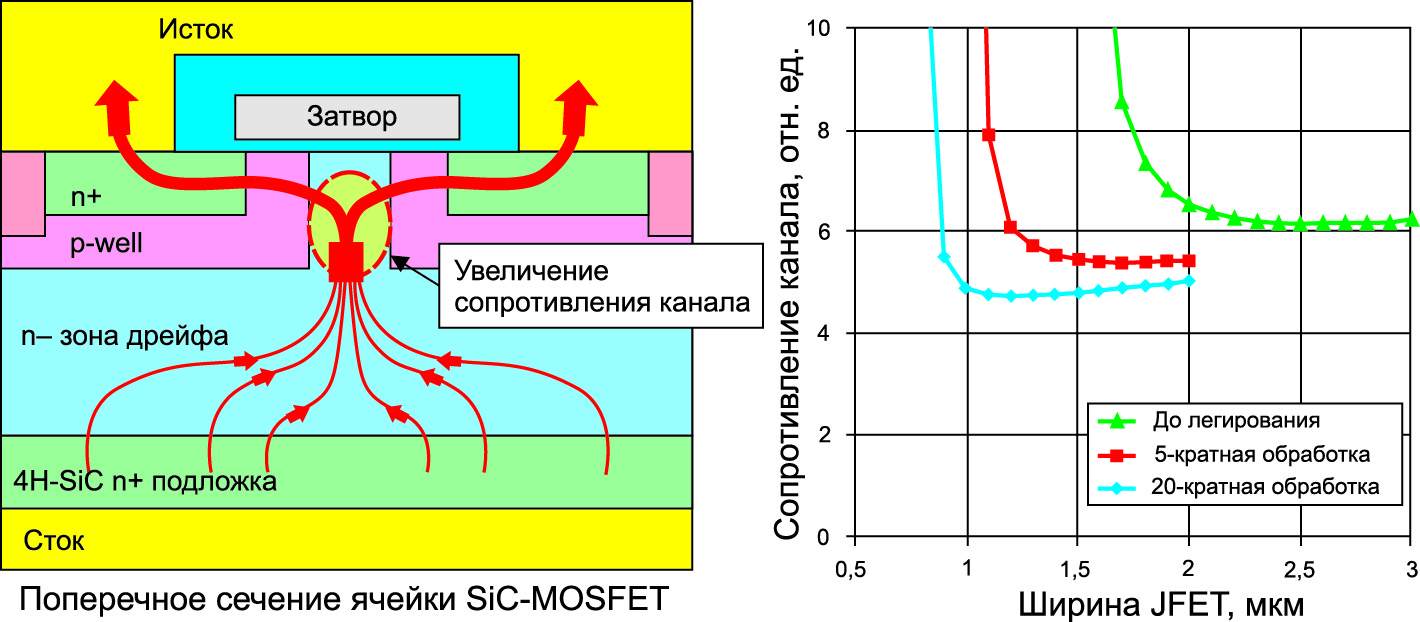


 24 августа, 2021
24 августа, 2021 20 мая, 2020
20 мая, 2020