1800 A/3,3 кВ IGBT-модуль с пазовой структурой затвора Advanced Trench HiGT и оптимизированной конструкцией
Введение
IGBT-модули на напряжение 3,3 кВ широко используются в тяговых преобразователях электротранспорта [1], преобразователях среднего и высокого уровней напряжений [2] с конфигурацией второго и третьего уровней, а также в узлах многоуровневых преобразователей. В перечисленных многоцелевых приложениях одним из стандартных размеров корпусов таких модулей является их исполнение с габаритами 140×190×38 мм (рис. 1), а самый высокий доступный на сегодняшний рабочий ток модуля составляет 1500 A. Таким образом, имеется потребность в разработке IGBT-модулей, имеющих более высокий выходной ток, но при этом сохраняющих совместимость с корпусами модулей указанного выше типоразмера, и, что еще особенно важно, необходимо снизить затраты на проведение таких опытно-конструкторских работ.

Рис. 1. Тенденция развития IGBT-модуля компании Hitachi с рабочим напряжением 3,3 кВ (слева) и внешний вид IGBT-модуля с габаритами 140×190 мм (справа)
Именно для удовлетворения имеющейся в настоящее время потребности со стороны самых различных приложений был разработан представленный новый IGBT-модуль с высоким номинальным рабочим током. Чтобы решить такую сложную задачу, важно было не только адаптировать к ней кремниевые чипы с низкими потерями, но и выполнить мероприятия по оптимизации корпуса модуля в целом в части улучшения его тепловых, механических и электрических характеристик. Ранее мы уже демонстрировали исполнение упомянутых выше кремниевых чипов с малыми потерями, что было достигнуто без ухудшения при этом их управляемости со стороны затвора [3–5].
Цель ОКР и выработка концепции конструкции
На рис. 1 представлена тенденция развития IGBT-модулей компании Hitachi, рассчитанных на рабочие напряжения 3,3 кВ, в части номинального рабочего тока, температуры перехода, а также типового значения Vce(sat) (прим.перев.: Vce(sat) — напряжение насыщения «коллектор–эмиттер»). Все указанное относится к уже традиционном типу продукции с максимальными токами в 1500 и 1000 A для типоразмеров корпусов 140×190×38 мм и 140×130×38 мм соответственно.
В ходе представляемой опытно-конструкторской работы специалисты стремились увеличить номинальный рабочий ток модуля на 20% от уже обычного максимального в 1500 A, т. е. достичь уровня номинального рабочего тока модуля в 1800 A. В таблице показаны поставленные цели и пути их реализации в рассматриваемом проекте.
|
Параметры |
Цель |
Действие |
||
|
Номинальный рабочий ток, А |
+20% |
– |
||
|
Размер корпуса |
Без изменения |
– |
||
|
Оптимизация тепловых характеристик |
Тепловое сопротивление Rth(j–c) |
<–20% |
Переработка чипа (в том числе и его габаритов). |
|
|
Потери (P) |
<–20% |
Модернизация чипа (Advanced Trench HiGT). |
||
|
Сопротивление выводов модуля |
<–44% |
Новая конструкция терминала (снижение электрического сопротивления). Ультразвуковая сварка (терминал–подложка). |
||
|
Оптимизация электрических характеристик |
Паразитная индуктивность |
–40% |
Новая конструкция терминала (уплотнение компоновки терминалов). |
|
|
Управление затвором Vg–Qg |
Без изменения |
Модернизация чипа (Advanced Trench HiGT). |
||
|
Устойчивость |
RBSOA |
+20% |
Модернизация чипа (Advanced Trench Higt). Уменьшение паразитной индуктивности. Подавление дисбаланса внутренней индуктивности. |
|
|
RRSOA |
+20% |
Уменьшение паразитной индуктивности. Расширение активной зоны. Подавление дисбаланса внутренней индуктивности. |
||
|
SCSOA |
Без изменения |
Модернизация чипа (Advanced Trench HiGT). Подавление дисбаланса внутренней индуктивности. |
||
|
I2t |
>+44% |
Снижение потерь проводимости. Снижение теплового сопротивления. |
||
Цель оптимизации тепловых характеристик
Для начала воспользуемся следующей формулой:
ΔTj=P×Rth(j–ambient)=Const (1)
где ΔTj — приращение температуры по отношению к температуре окружающей среды; P — мощность, рассеиваемая на модуле (мощность потерь); Rth (j–ambient) — тепловое сопротивление «переход–окружающая среда».
Rth (j–ambient) вычисляется по формуле:
Rth(j–ambient)=Rth(j–c)+Rth(c–hs)+Rth(hs-ambient), (2)
где Rth(j–c) — тепловое сопротивление «переход–корпус» модуля; Rth(c–hs) — тепловое сопротивление «корпус–теплоотвод (радиатор)» модуля; Rth(hs–ambient) — тепловое сопротивление «корпус–окружающая среда» модуля.
Понятно, что если рассматривать вариант замены уже освоенного серийного изделия, которое примем за прототип, то в этом случае снижение таких составляющих формулы, как тепловые сопротивления Rth(c–hs) и Rth(hs–ambient), не будет иметь места. Таким образом, если мы установили, что целью оптимизации должно быть снижение более чем на 20% составляющей Rth(j–c), то при этом и мощность потерь P должна быть также уменьшена не менее чем на 20%. Концепция выбора таких целевых величин заключается в следующем. В первом приближении потери на переключение пропорциональны току коллектора IC. По этой причине если ток IC увеличится на 20%, то и потери на переключение, как ожидается, увеличатся на 20%.
Кроме того, есть такое правило, что кондуктивные потери, или потери проводимости, пропорциональны 3/2 от увеличения тока коллектора IC. По этой причине потери на проводимость увеличиваются на 30%, если ток IC будет увеличен на 20%. Таким образом, если это, конечно, возможно, то величину общего (суммарного) теплового сопротивления Rth(j–ambient) желательно уменьшить на 20–30%. Тем не менее уменьшение даже на 20% величины Rth(j–c) приводит к уменьшению теплового сопротивления Rth(j–ambient) приблизительно на 10%, если не больше. Поэтому было решено сократить на 20% потери мощности (P), чтобы уменьшить величину ΔTj.
Кроме того, чтобы сохранить на прежнем уровне имеющуюся температуру терминалов (выводов модуля, клемм), необходимо уменьшить их собственное сопротивление не менее чем на 44%.
Цель оптимизации электрических характеристик
Снижение паразитной индуктивности
Отправной точкой для рассмотрения этого вопроса является следующее. Для подавления выбросов напряжения, по аналогии с освоенным прототипом, имеем:
где ΔVCE — приращение напряжения коллектор-эмиттер под действием паразитной индуктивности; LS — паразитная индуктивность; Ic — ток коллектора; dIc/dt — скорость его нарастания.
Паразитная индуктивность LS, в свою очередь, равна:
Ls=2×Ls(IGBT)+Ls(Busbar)+Ls(Capacitor), (4)
где LS (IGBT) — паразитная индуктивность IGBT; LS (Busbar) — паразитная индуктивность шины; LS (Capacitor) — паразитная индуктивность конденсатора.
В оптимизированной системе паразитные индуктивности Ls(Busbar) и Ls(Capacitor) остаются практически теми же самыми. Так что в случае замены прототипа на его модернизированную версию это не приведет к уменьшению паразитных индуктивностей Ls(Busbar) и Ls(Capacitor). Таким образом, мы установили, что целью может быть только лишь сокращение более чем на 40% величины паразитной индуктивности непосредственно самого IGBT, т. е. Ls(IGBT).
Совместимость по управлению затвором
Кроме того, очень важно учитывать требование совместимости по управлению затвором. Это необходимо для того, чтобы была возможность легко заменить уже имеющиеся модули. Потери мощности PG схемы драйвера затвора могут быть рассчитаны путем рассмотрения влияния электрических характеристик, определяющих заряд емкости затвора. Они представлены следующим уравнением:
PG={|VGP|+|VGN|}×QG× QG, (5)
где: PG — потери мощности на затворе; |VGP| — модуль напряжения включения на затворе; |VGN| — модуль напряжения запирания на затвор; QG — заряд затвора; QG — частота коммутации.
Таким образом, необходимый заряд затвора QG должен быть или аналогичным, или меньше, чем у прототипа.
Электрическая стойкость(области безопасной работы)
Параметрами, описывающими электрическую устойчивость, необходимыми для оценки IGBT, являются: RBSOA (область безопасной работы в выключенном состоянии c обратным смещением), RRSOA (область безопасной работы обратного диода), SCSOA (область безопасной работы при коротком замыкании), а также выброс тока включения. Устойчивость к броскам тока представлена значением I2t, приведенным в спецификации. Для реализации задачи повышения номинального тока модуля на 20% устанавливаем требования следующим образом: области безопасной работы RBSOA и RRSOA увеличиваем не менее чем на 20%, область SCSOA оставляем той же, значение тока I2t увеличиваем не менее чем на 44% при температуре перехода Tj = +150 °C.
Конструкция корпуса
С точки зрения обеспечения совместимости, размеры корпуса нового модуля остаются такими же, как и у прототипа.
Уменьшение потерь путем использования технологии Advanced Trench HiGT в модуле на рабочее напряжение 3,3 кВ
В новом IGBT-модуле применена новая пазовая структура затвора (Advanced Trench HiGT [4–5]) с глубоким плавающим р-слоем. Это необходимо для того, чтобы путем некоторого компромисса реализовать необходимое улучшение характеристики напряжения насыщения Vce(sat) в зависимости от потерь энергии при выключении Eoff. Толщина объемного слоя n-типа и структуры подложки выполнены и оптимизированы для обеспечения мягкой коммутации и уменьшения выброса напряжения на коллекторе Vce при выключении. Развитая структура паза типа HiGT показана на рис. 2 в сравнении с взятым за основу серийным прототипом IGBT. Структуры с плавающим р-слоем отделены от пазов затвора. Такая структура затвора может уменьшить VGE перерегулирование IGBT-модуля при включении, и в то же время ток Irp диода, защищающего модуль от обратного напряжения, уменьшается.

Рис. 2. Структура узла ячейки IGBT
Улучшение, достигнутое в виде компромисса, зависимости Vce(sat) от Eoff и компромиссного решения в части зависимости VF от Eon+Err (потери энергии на переключение и включение) для нового IGBT-модуля, показаны на рис. 3.

Рис. 3. Достигнутый компромисс по отношению к прототипу
Переработка чипа для оптимизации тепловых и электрических характеристик
С целью оптимизации теплового сопротивления предлагается перестроить внутреннюю структуру чипа. При этом области диодов увеличиваются и диспергируются (рассредоточиваются) в целях более эффективного распространения тепла. Увеличение области диодов также необходимо для большей устойчивости к воздействию бросков (импульсов) тока [7]. Были разработаны три модели компоновки, которые были оценены с точки зрения уменьшения дисбаланса температуры перехода и паразитной индуктивности. Преимущества и недостатки каждого варианта показаны на рис. 4.
Расположение в линию, из-за легкости выравнивания длин проводов, является лучшим с электрической точки зрения в части удобства подключения. Но при таком расположении так называемая «горячая точка» (место наибольшего нагрева) будет образовываться благодаря тепловой интерференции (взаимному нагреву). С другой стороны, шахматное расположение является лучшим с тепловой точки зрения из-за подавления тепловой интерференции, но в этом случае трудно подавить дисбаланс паразитной индуктивности и уменьшить его путем асимметричной структуры. В качестве компромисса выбрано псевдошахматное расположение.
На рис. 5 показано сравнение по несбалансированности паразитной индуктивности и дисбалансу токов. Распределение тока в псевдошахматном порядке остается на таком же уровне, что и у прототипа. В результате без ухудшения электрических характеристик достигается уменьшение теплового сопротивления на 20%.
Изменение конструкции терминалов для снижения их паразитной индуктивности и собственного сопротивления
Конструкция терминалов (выводов модуля) оптимизирована с целью уменьшения их паразитной индуктивности и сопротивления. На рис. 6 представлено сравнение конструкции основного терминала [8]. Терминалы эмиттера и коллектора нового IGBT-модуля теперь расположены близко друг к другу, как параллельные пластины. Кроме того, чтобы свести к минимуму его собственное сопротивление, площадь поперечного сечения терминала увеличивается, а длина терминала уменьшается.

Рис. 6. Сравнение структуры основного терминала (моделирование паразитной индуктивности):
а) прототип;
б) новый IGBT-модуль
Чтобы обеспечить высокую надежность при протекании больших токов, подключение внутренних соединений осуществляется методом ультразвуковой сварки. Структура со снятием внутренних напряжений предназначена для снижения механической нагрузки на точки подключения терминалов к подложке и полупроводниковому переходу, на которые воздействует циклический тепловой удар. Кроме того, специально регулируется дисбаланс индуктивности, чтобы подавить токовый дисбаланс между подложками.
В результате достигнуто уменьшение собственного сопротивления терминала и снижение его паразитной индуктивности соответственно на 40 и 45%. Причем, при том же увеличении температуры терминала, ток через него теперь может быть увеличен на 15% по сравнению с прототипами (рис. 7).

Рис. 7. Результат измерения температуры терминала нового IGBT-модуля:
a) изображение распределения температуры терминала на экране тепловизора;
б) сравнение по температуре терминалов
Электрические характеристики
Характеристики заряда емкости затвора
Характеристика заряда емкости затвора новых IGBT-модулей соответствует обычной (рис. 8). Таким образом, новые IGBT-модули могут легко заменить имеющиеся в настоящее время.
Электрическая стойкость (области безопасной работы)
На рис. 9 показана форма волны RBSOA и RRSOA, на рис. 10 — форма волны SCSOA и I2t. Согласно этим результатам, поставленные цели в части электрической прочности достигнуты.
Максимальный ток фазы
Максимальный среднеквадратичный ток фазы вычислен и показан на рис. 11. При достижении заявленных целей, указанных в таблице, достигается увеличение выходного тока на 20%.
Заключение
Был разработан 1800 A/3,3 кВ IGBT-модуль с самым высоким номинальным током, который на 20% больше по сравнению с обычными модулями. Он может быть использован для замены обычных продуктов без модификации радиаторов, конденсаторов, шин подключения и драйверов затвора. В результате проделанной работы достигнуто 20%-ное увеличение выходного тока.
- Nagel, M. Bakran. Robustness Requirements on Semiconductors for High Power Applications // Proc. 15th EPE. 2013.
- S. Jones, C.C. Davidson. Calculation of Power Losses for MMC-based VSC HVDC Station // Proc. 15th EPE. 2013.
- Mori, K. Oyama, Y. Kohno, J. Sakano, J. Uruno, K. Ishizaka, D. Kawase. A Trench-Gate High-Conductivity IGBT (HiGT) With Short-Circuit Capability // IEEE Transact. on Elec. Dev. 2007. Vol. 54, № 8.
- Arai, S. Watanabe, K. Ishibashi, Y. Toyoda, T. Oda, K. Saito, M. Mori. The Advanced Trench HiGT with Separate Floating p-Layer for Easy Controllability and Robustness // Proc. PCIM Europe. 2011.
- Toyota, M. Wakagi, K. Ishibashi, H. Mizue, Y. Shima, T. Oda, D. Kawase, K. Saito and M. Mori. Novel 3.3-kV Advanced Trench HiGT with Low Loss and Low dv/dt Noise // Proc. 25th ISPSD. 2013.
- Hitachi Power Semiconductor Device, Ltd. Application Manual for High voltage IGBT module. hitachi-power-semiconductor-device.co.jp/en/product/igbt/attention.html
- Lutz, H. Shlangenotto, U. Scheuermann, R. De Doncker. Semiconductor Power Devices. Physics, Characteristics, Reliability. Springer, 2011.
- Azuma, I. Yoshida, A. Konno, Y. Toyoda, K. Saito. New 3.3kV IGBT Module with Low Power Loss and High Current Rating // Proc. PCIM Europe. 2013.





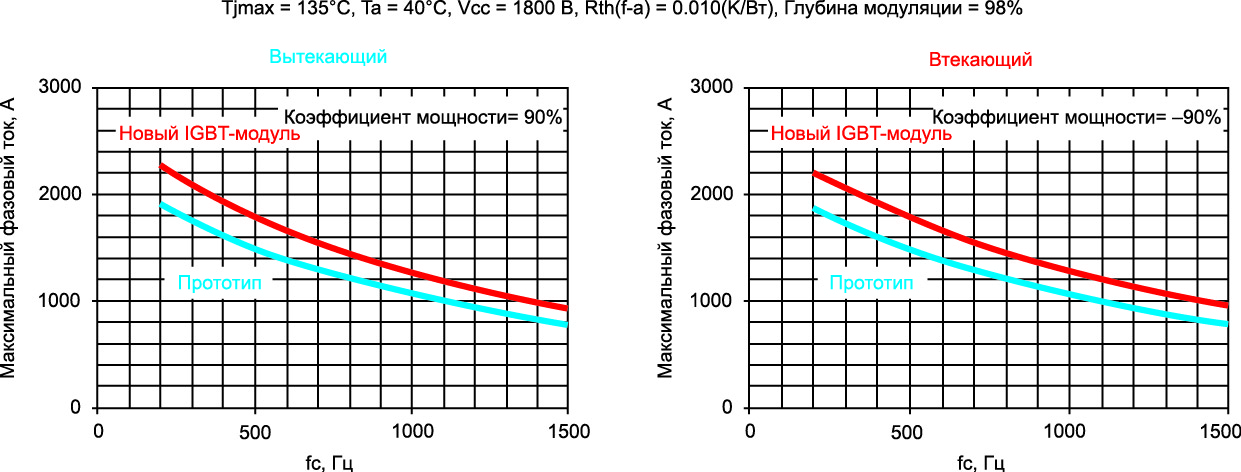
 5 сентября, 2011
5 сентября, 2011 26 мая, 2020
26 мая, 2020