Гибридный силовой транзистор IGBT — статистические и динамические характеристики
Однако актуальными задачами все еще остаются снижение остаточного падения напряжения на IGBT в проводящем состоянии и улучшение стойкости прибора к токовым и температурным перегрузкам. Биполярный p-n-p-транзистор, входящий в состав ячейки IGBT, невозможно перевести в режим насыщения: он принципиально остается в активном режиме. Это приводит к тому, что падение напряжения на открытом IGBT составляет единицы вольт, уступая в несколько раз силовым биполярным транзисторам (БТ) и тиристорам. Кроме того, коллектор БТ, входящий в базовую ячейку IGBT, и область истока полевого транзистора МОПТ необходимо шунтировать общей металлизацией для подавления активной работы паразитной p-n-p-n-структуры, самопроизвольно включающейся в режимах перегрузки (эффект «защелкивания» в IGBT, приводящий к потере управляемости ключом).
Все эти проблемы требуют постоянного усовершенствования технологий IGBT, главным направлением развития которых является изменение картины распределения профиля носителей в базовой области прибора (технология Trench-Gate с эффектами усиленной инжекции и накопления носителей). Однако подобные решения весьма дорогостоящи, технологически сложны и доступны только для мировых лидеров в области создания силовых приборов.
Остановимся на некоторых физических явлениях в структуре IGBT, позволяющих предложить техническое решение указанных выше проблем. Во-первых, это фундаментальный эффект смыкания p-областей объемного заряда в канале IGBT, разрешающий использовать низковольтный полевой транзистор МОПТ в монолитной структуре прибора. За счет данного эффекта обеспечивается статическая и динамическая отсечка высокого потенциала со стороны коллектора. Во-вторых, одним из возможных вариантов, подавляющих эффект «защелкивания», является разделение p-областей коллектора составного биполярного транзистора БТ и истока низковольтного полевого транзистора МОПТ. В монолитной ячейке IGBT этого достичь практически невозможно. Вот почему и было предложено разделение структуры IGBT на два отдельных монокристалла: высоковольтный p-i-n-диод с полевым управлением (аналог силового тиристора с электростатическим управлением — ТЭУ) и низковольтный управляющий полевой транзистор. В структуре ключа оба монокристалла соединены по гибридной технологии (рис. 2), что и определило его название — гибридный IGBT (H-IGBT).
Аббревиатура IGBT в названии гибридного ключа оставлена по следующим соображениям:
- Эквивалентные схемы гибридного и монолитного IGBT практически совпадают [1].
- Функциональные аналоги обоих транзисторов размещаются в идентичных серийных корпусах и имеют одинаковые массо-габаритные показатели.
- Сравнительное исследование динамических параметров силовых модулей и дискретных ключей данных аналогов демонстрирует схожие, а в ряде случаев одинаковые показатели.
4. Управление обоими типами ключей осуществляется от одинаковых серийных драйверов.
В то же время гибридный IGBT имеет целый ряд преимуществ:
- Остаточное падение напряжения существенно меньше, чем у монолитных IGBT за счет насыщения внутреннего p—n—p-транзистора.
- Полностью подавлен эффект «защелкивания».
- Каскадная схема соединения приводит к значительному уменьшению эффекта Миллера в переходном процессе переключения гибридного IGBT.
- Существенно увеличена стойкость к эффекту dU/dt, что позволяет обходиться без источника отрицательного смещения в цепи затвора.
5. Доступ к целому ряду характерных точек конструкции ключа позволяет считывать важную информацию о его работе. Основные характеристики, параметры и конструктивные особенности гибридного IGBT достаточно подробно были рассмотрены в предыдущих статьях, опубликованных в журнале «Силовая электроника». В настоящей статье приводятся новые результаты исследования вольт-амперных характеристик (ВАХ) гибридных IGBT с различным временем жизни носителей, полученным посредством электронного облучения.
Результаты исследования ВАХ в полном диапазоне токов нагрузки представлены на рис. 3, а в области малых плотностей тока — на рис. 4.

Рис. 3. ВАХ гибридного IGBT

Рис. 4. ВАХ гибридного IGBT в области малых плотностей тока
В этих характеристиках номера соответствуют приборам с различными дозами облучения:
- Без облучения (tt = 12 мкс).
- Доза облучения — 1 (tt = 4 мкс).
- Доза облучения — 2 (tt = 2 мкс).
- Доза облучения — 3 (tt = 1 мкс).
- Доза облучения — 4 (tt = 0,6 мкс).
- Доза облучения — 5 (tt = 0,4 мкс).
- Доза облучения — 6 (tt = 0,1 мкс).
Как и в монолитных IGBT первого-второго поколения, на статических ВАХ (кривые 3-7) наблюдаются области отрицательного дифференциального сопротивления ОДС (S-об-разные ВАХ). Наличие ОДС на ВАХ транзисторов с изолированным затвором объясняется следующим образом [4]. При малых токах, то есть при малых уровнях инжекции время жизни носителей также невелико (τ/τpo< 10) и эффект модуляции проводимости n—-базы транзистора слабо выражен. При переходе
к области относительно высоких плотностей тока (j > 30 А/см2) сопротивление «–-базы сильно уменьшается. Это снижение сопротивления тем резче, чем больше отношение времени жизни носителей при высоком и низком уровне инжекции. Как правило, ОДС проявляется, если τ/τpo ≥50-100. Чем меньше время жизни, тем ОДС больше и по току, и по напряжению. С увеличением тока нагрузки ОДС исчезает. Такое соотношение времен характерно для IGBT-транзисторов с сильно легированным буферным слоем n’. В структурах без n’-слоя эффект не проявляется, так как переход к большому уровню инжекции в подобных приборах происходит уже при сравнительно малых токах нагрузки.
Следует упомянуть также влияние степени легирования буферного слоя n’ на эффект «защелкивания». Чем выше степень легирования этого слоя, тем выше плотность тока, при которой наступает упомянутый эффект. Следовательно, для гибридного IGBT, где эффект «защелкивания» устранен конструктивным решением, возможно более рациональное решение по выбору оптимальной величины степени легирования слоя n’.
На рис. 5, 6 показано влияние величины форсирующего заряда на фронт включения гибридного IGBT. Для осуществления диодного режима в высоковольтном кристалле прибора его затвор должен находиться в режиме «плавающего» потенциала. Однако в процессе выключения необходимо обеспечить качественную шунтировку затвора на общую шину. Данное переключение обеспечивается в структуре ключа дополнительным регулирующим элементом (РЭ). Динамика процесса включения-выключения РЭ определяет качество переходных процессов ключа в целом. Например, при включении важным моментом является обеспечение дополнительного форсирующего заряда в базовую цепь гибридного IGBT. Если динамика переключения регулирующего элемента относительно медленна, то может происходить шунтировка этим элементом форсирующего тока от драйвера, и фронт включения IGBT значительно ухудшается. При выключении прибора высокое сопротивление в цепи затвора р-г-п-диода при медленном переключении регулирующего элемента может приводить к динамической перегрузке управляющего полевого транзистора.

Рис. 5. Включение при форсирующем
заряде 75 нК:
1 — Ugs(10 В/дел),
2 — Uds(100 В/дел),
3 — Id(5 А/дел)
Структура и технология нового ключа были разработаны специалистами ВЭИ и МЭИ в рамках государственной программы «Национальная технологическая база» [2, 3]. К выпуску гибридного IGBT первого поколения в 2006 г. приступила компания ОАО НПО «Энергомодуль» (г. Троицк, Московская область).
- Воронин П. А. Силовые полупроводниковые ключи. Семейства, характеристики, применение. М.: Додека — XXI, 2001.
- Полупроводниковое ключевое устройство с полевым управлением. Патент РФ № 2199795. Опубл. 27.02.2003. Бюл. № 6.
- Полупроводниковое ключевое устройство. Патент РФ RU2268545С2. Опубл. 20.01.2006. Бюл. № 2.
- Кузьмин В. А., Юрков С. Н, Поморцева Л. И. Анализ и моделирование статических характеристик биполярных транзисторов с изолированным затвором // Радиотехника и электроника. 1996, том 41, № 7.


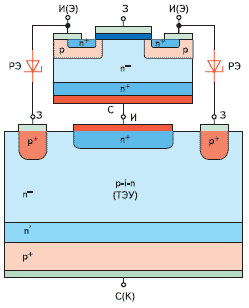

 25 сентября, 2007
25 сентября, 2007 8 октября, 2012
8 октября, 2012